세계 최초 128GB D램 모듈 양산…삼성, 15개월 만에 '메모리 반도체 신화' 또 썼다
TSV 신기술 적용
풀HD 영화 15편 한꺼번에 처리
속도 2배↑·전력소모 50%↓
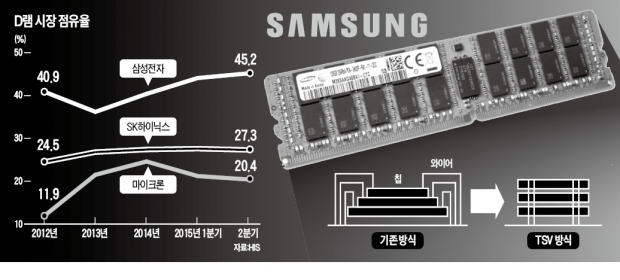
◆세 마리 토끼 잡은 신기술 TSV
삼성전자는 TSV 기술을 적용한 128GB 서버용 D램 모듈 생산에 들어갔다고 26일 발표했다. 작년 8월 64GB 제품을 내놓은 뒤 15개월 만에 용량을 두 배로 늘렸다. 이 모듈엔 20나노 공정에서 만든 8기가비트(Gb) DDR4 D램 칩이 144개 들어간다.
용량뿐만 아니다. TSV 기술은 완성된 칩을 회로기판에 심는 첨단 후공정(패키징) 기술이다. 과거엔 칩을 회로기판에 심은 뒤 전기선을 연결해 썼지만(와이어본딩), 이제는 칩을 쌓은 뒤 그 실리콘기판을 뚫고 전극으로 연결한다. 와이어본딩 방식에 비해 데이터 전송 거리가 줄어 처리 속도가 빨라지고, 최단 거리로 전류가 이동해 전력소비를 대폭 줄일 수 있으며, 크기도 작아져 기기를 얇게 만들 수 있다.
실제 이번 제품은 64GB제품보다 속도가 두 배 정도 빠르고, 소비전력량은 50% 적다.
정보기술(IT) 시장에서 큰 주목을 받을 것이라는 관측이 나온다. 소셜네트워크서비스(SNS)나 클라우드 등 모바일 기반 서비스가 확산되면서 데이터가 폭증하고 있어서다.
◆3D에서 TSV 기술까지
반도체는 그동안 공정 미세화를 통해 용량을 키워 왔다. 회로선 폭을 줄여 같은 공간에 들어가는 셀 수를 늘린 것이다. 하지만 미세공정은 10나노(10억분의 1m)에 달하면서 한계에 부딪혔다. 기술 개발 속도가 느려졌고 개발 비용도 많이 든다. 그래서 나온 게 쌓는 3D 기술과 뚫는 TSV 기술이다.
셀을 위로 쌓아 만드는 3D 기술은 구조가 간단한 낸드플래시 메모리에만 쓰인다. 삼성전자는 2013년 8월부터 생산을 시작했으며 최근 48단까지 쌓아 용량을 256Gb까지 늘린 제품을 내놓았다.
업계 관계자는 “3D 기술은 위로 쌓으면 쌓을수록 용량이 커지는 데다 셀 간 간섭이 줄어 신뢰성이 높고 소비전력도 적다”고 설명했다.
D램에는 후공정 기술인 TSV가 적용된다. 그동안은 회로기판에 꽃은 뒤 전기선으로 칩과 칩, 칩과 기판을 연결했다. 이게 와이어본딩이다. 하지만 용량을 높이다 보면 선이 길어지고 복잡해진다. 그래서 기존 와이어본딩은 64GB가 한계로 여겨졌다. 이 때문에 개발한 게 TSV 기술이다.
D램 칩을 일반 종이 절반보다 얇게 깎아 쌓은 다음 수백 개의 미세한 구멍을 뚫고 위아래 칩의 구멍을 수직으로 관통하는 전극으로 연결하는 것이다.
김현석 기자 realist@hankyung.com
-
기사 스크랩
-
공유
-
프린트
![[속보] 비트코인 반감기 완료…"가격 0.47% 하락"](https://img.hankyung.com/photo/202404/02.22579247.3.jpg)

!["오븐에 넣기만 하면 요리 끝"…역대급 '중국 가전' 등장 [르포]](https://img.hankyung.com/photo/202404/01.36473102.3.jpg)


![하루 만에 550조원 증발…실적·물가 압력에 기술주 투매 [글로벌마켓 A/S]](https://timg.hankyung.com/t/560x0/photo/202404/B20240206081554930.jpg)


![[단독] "경영보다 돈"…아워홈 매각 손잡은 남매](https://timg.hankyung.com/t/560x0/photo/202404/AA.36472890.1.jpg)





![[신간] 로마 제국이 '최고 국가'로 우뚝 서기까지…'팍스'](https://timg.hankyung.com/t/560x0/photo/202404/ZK.36477517.3.jpg)